当前位置:
X-MOL 学术
›
ACS Appl. Mater. Interfaces
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Thermal and Plasma-Enhanced Atomic Layer Deposition of Yttrium Oxide Films and the Properties of Water Wettability.
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2019-12-20 , DOI: 10.1021/acsami.9b18412
Bo Zhao 1 , Felix Mattelaer 1 , Geert Rampelberg 1 , Jolien Dendooven 1 , Christophe Detavernier 1
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2019-12-20 , DOI: 10.1021/acsami.9b18412
Bo Zhao 1 , Felix Mattelaer 1 , Geert Rampelberg 1 , Jolien Dendooven 1 , Christophe Detavernier 1
Affiliation
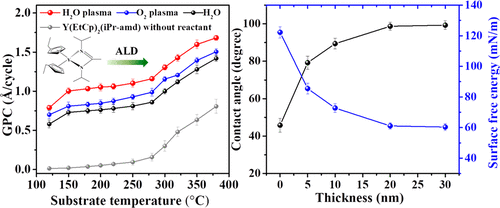
|
The atomic layer deposition (ALD) of yttrium oxide (Y2O3) is investigated using the liquid precursor Y(EtCp)2(iPr-amd) as the yttrium source with thermal (H2O) and plasma-enhanced (H2O plasma and O2 plasma) processes, respectively. Saturation is confirmed for the growth of the Y2O3 films with each investigated reactant with a similar ALD window from 150 to 300 °C, albeit with a different growth rate. All of the as-deposited Y2O3 films are pure and smooth and have a polycrystalline cubic structure. The as-deposited Y2O3 films are hydrophobic with water contact angles >90°. The water contact angle gradually increased and the surface free energy gradually decreased as the film thickness increased, reaching a saturated value at a Y2O3 film thickness of ∼20 nm. The hydrophobicity was retained during post-ALD annealed at 500 °C in static air for 2 h. Exposure to polar and nonpolar solvents influences the Y2O3 water contact angle. The reported ALD process for Y2O3 films may find potential applications in the field of hydrophobic coatings.
中文翻译:

氧化钇膜的热和等离子体增强原子层沉积以及水的润湿性。
以液态前驱体Y(EtCp)2(iPr-amd)为钇源,采用热(H2O)和等离子体增强(H2O等离子体和O2等离子体)工艺研究了氧化钇(Y2O3)的原子层沉积(ALD) , 分别。确认了在每种被研究的反应物下,Y2O3膜的生长都具有饱和,在150至300°C下具有相似的ALD窗口,尽管生长速率不同。所有沉积的Y2O3薄膜都是纯净光滑的,并具有多晶立方结构。沉积的Y2O3膜是疏水的,水接触角> 90°。随着膜厚度的增加,水接触角逐渐增大,表面自由能逐渐降低,在约20 nm的Y2O3膜厚度下达到饱和值。在静态空气中于500°C下进行ALD后退火2 h期间,疏水性得以保持。暴露于极性和非极性溶剂中会影响Y2O3与水的接触角。报道的Y2O3薄膜的ALD工艺可能在疏水涂层领域中找到潜在的应用。
更新日期:2020-01-04
中文翻译:

氧化钇膜的热和等离子体增强原子层沉积以及水的润湿性。
以液态前驱体Y(EtCp)2(iPr-amd)为钇源,采用热(H2O)和等离子体增强(H2O等离子体和O2等离子体)工艺研究了氧化钇(Y2O3)的原子层沉积(ALD) , 分别。确认了在每种被研究的反应物下,Y2O3膜的生长都具有饱和,在150至300°C下具有相似的ALD窗口,尽管生长速率不同。所有沉积的Y2O3薄膜都是纯净光滑的,并具有多晶立方结构。沉积的Y2O3膜是疏水的,水接触角> 90°。随着膜厚度的增加,水接触角逐渐增大,表面自由能逐渐降低,在约20 nm的Y2O3膜厚度下达到饱和值。在静态空气中于500°C下进行ALD后退火2 h期间,疏水性得以保持。暴露于极性和非极性溶剂中会影响Y2O3与水的接触角。报道的Y2O3薄膜的ALD工艺可能在疏水涂层领域中找到潜在的应用。

































 京公网安备 11010802027423号
京公网安备 11010802027423号