当前位置:
X-MOL 学术
›
Appl. Surf. Sci.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
了解 F–、HF 和 HF2– 对 SiO2 蚀刻的贡献,并揭示反应动力学以代表 SiO2 在 pH 值高达 5 时的蚀刻行为
Applied Surface Science ( IF 6.3 ) Pub Date : 2024-03-03 , DOI: 10.1016/j.apsusc.2024.159829
Bumsik Kim , Wonje Lee , Sangwoo Lim
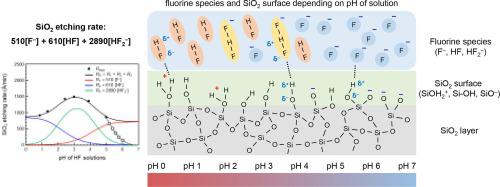
|
了解氢氟酸 (HF) 溶液中二氧化硅 (SiO) 蚀刻机制对于半导体制造工艺非常重要。先前对 SiO2 蚀刻机理的研究声称,只有二氟化物 (HF) 参与 SiO2 蚀刻。然而,在这项研究中,观察到 SiO2 的蚀刻发生在 HF 溶液中,其中几乎不存在二氟化物。因此,提出了一种新的 SiO 蚀刻机制和反应速率。在不同 pH 条件下使用不同浓度的 HF 和氟化铵 (NHF) 来蚀刻 SiO,导致 SiO 蚀刻速率为 510[F] + 610[HF] + 2890[HF] (Å/min)。 HF 是 SiO 蚀刻的主要贡献者;然而,与之前的SiO蚀刻机制不同,F和HF对SiO蚀刻的影响包含在SiO蚀刻速率中。考虑到具有不同 SiO2 表面状态的各种氟物质之间的反应,SiO2 蚀刻速率有效地代表了在更宽的 pH 范围(最高 pH 5)的各种条件下 SiO2 蚀刻行为。控制氟物质、F、HF、和 HF,我们的蚀刻模型也可以扩展到 SiO2 的选择性蚀刻。

"点击查看英文标题和摘要"

































 京公网安备 11010802027423号
京公网安备 11010802027423号