当前位置:
X-MOL 学术
›
Microelectron. Eng.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
椭圆偏振和 XPS 能量损失的混合:SiGe、HfON 和 MoOx 薄膜的鲁棒带隙和宽带光学常数测定
Microelectronic Engineering ( IF 2.6 ) Pub Date : 2023-10-29 , DOI: 10.1016/j.mee.2023.112117
Théo Levert , Alter Zakhtser , Julien Duval , Chloé Raguenez , Stéphane Verdier , Delphine Le Cunff , Jean-Hervé Tortai , Bernard Pelissier

"点击查看英文标题和摘要"
更新日期:2023-10-29
Microelectronic Engineering ( IF 2.6 ) Pub Date : 2023-10-29 , DOI: 10.1016/j.mee.2023.112117
Théo Levert , Alter Zakhtser , Julien Duval , Chloé Raguenez , Stéphane Verdier , Delphine Le Cunff , Jean-Hervé Tortai , Bernard Pelissier
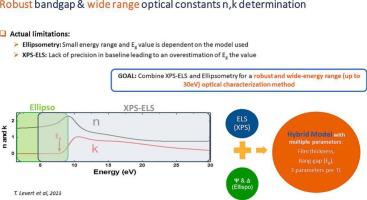
|
在本研究中,我们结合两种技术:光谱椭圆光度法和能量损失信号 (ELS),比较了三种不同材料:SiGe、N 掺杂 HfO 2和 MoO x的光学常数和光学带隙测定的鲁棒性。X 射线光电子能谱 (XPS)。这种物理性质的确定是通过基于多重 Tauc-Lorentz 模型的两种技术的混合来实现的,应用于整个测量能量范围。
这种混合数据的使用展示了一种新的稳健方法来确定所研究材料的带隙,以及宽能量范围(高达 40 eV)上的光学指数(折射率和消光系数)。与每种技术本身相比,该方法提供了相关物理量确定的扩展。
此外,该算法是在极限条件下进行测试的,其中两种技术的测量能量范围没有重叠。然而,使用独特的物理模型仍然允许我们即使在未执行测量的能量范围内计算不同的物理量,从而验证了混合技术的半预测性质。不同实验配置下的额外测量验证了这种混合技术的扩展范围。

"点击查看英文标题和摘要"

































 京公网安备 11010802027423号
京公网安备 11010802027423号