Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
洞察In2O3:H薄膜的高迁移率和稳定性
Small ( IF 13.0 ) Pub Date : 2023-09-05 , DOI: 10.1002/smll.202304721
Ciyu Ge 1 , Zunyu Liu 1 , Yongchen Zhu 1 , Yilong Zhou 1 , Borui Jiang 1 , Jiaxing Zhu 1 , Xuke Yang 1 , Yongxin Zhu 1 , Shuyu Yan 1 , Haojun Hu 1 , Haisheng Song 1 , Luying Li 1 , Chao Chen 1, 2 , Jiang Tang 1, 2
Affiliation
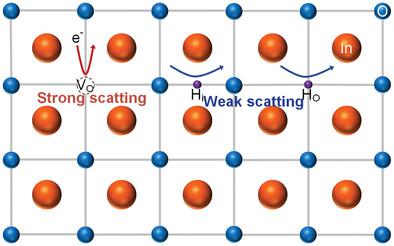
|
宽带隙半导体,特别是In 2 O 3 :Sn (ITO),广泛用作光电器件中的透明导电电极。然而,由于高浓度氧空位(V O )缺陷的散射概率,ITO的迁移率始终低于40 cm 2 V -1 s -1 。最近,氢掺杂的In 2 O 3 (In 2 O 3 :H)薄膜已被证明具有高迁移率(>100 cm 2 V -1 s -1 ),但这种高迁移率的起源仍不清楚。在此,采用高分辨率电子显微镜和理论计算来研究In 2 O 3 :H薄膜中高载流子迁移率背后的原子尺度机制。研究发现V O会引起强烈的晶格畸变和大的载流子散射概率,导致载流子迁移率低。此外,氢掺杂可以同时降低V2O的浓度,从而实现高载流子迁移率。研究了In 2 O 3 :H薄膜的热稳定性和酸碱腐蚀机理,发现在高温(>250℃)下氢气会从薄膜中溢出,而酸性或碱性环境会对In 2 O 3 :H薄膜造成损害。 O 3谷物本身。总的来说,这项工作提供了对In 2 O 3 :H中高载流子迁移率的根本原因的见解,并为透明导电氧化物的掺杂和稳定机制提供了一种新的研究方法。

"点击查看英文标题和摘要"

































 京公网安备 11010802027423号
京公网安备 11010802027423号