Microelectronic Engineering ( IF 2.6 ) Pub Date : 2023-06-21 , DOI: 10.1016/j.mee.2023.112056 Fuliang Wang , Xi He , Bo Wu , Qingyu Li , Qibin Niu , Kai Niu , Wenhao Yao
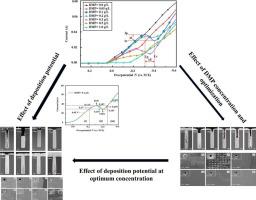
|
Through silicon via (TSV) is the core technology that implements three-dimensional (3D) integrated packaging in integrated circuits. Electrodeposition defects affect the reliability of TSVs. In particular, the surface Cu protrusions can lead to structural deformations, which significantly affect the reliability of TSVs. In this study, 4,6-Dimethyl-2-mercaptopyrimidine (DMP) is studied as a leveller additive for TSV electroplating, along with the effect of the deposition parameters on the TSV filling process and surface morphology. To evaluate the filling performance of DMP, linear sweep voltammetry (LSV) is performed to investigate how the additives affect the filling mechanism. Finally, the conditions of this levelling agent in TSV plating are predicted based on LSV curves and validated using plating experiments.
中文翻译:

用于减轻硅通孔填充中铜突出的 4,6-二甲基-2-巯基嘧啶的参数分析和电化学性能
硅通孔(TSV)是在集成电路中实现三维(3D)集成封装的核心技术。电沉积缺陷影响 TSV 的可靠性。特别是,表面铜突起会导致结构变形,从而显着影响 TSV 的可靠性。在本研究中,研究了 4,6-二甲基-2-巯基嘧啶 (DMP) 作为 TSV 电镀的整平添加剂,以及沉积参数对 TSV 填充过程和表面形态的影响。为了评估 DMP 的填充性能,线性扫描伏安法 (LSV) 用于研究添加剂如何影响填充机制。最后,根据LSV曲线预测了该整平剂在TSV电镀中的条件,并通过电镀实验进行了验证。






































 京公网安备 11010802027423号
京公网安备 11010802027423号