当前位置:
X-MOL 学术
›
ACS Appl. Mater. Interfaces
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Determination of Hafnium Zirconium Oxide Interfacial Band Alignments Using Internal Photoemission Spectroscopy and X-ray Photoelectron Spectroscopy
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2021-03-22 , DOI: 10.1021/acsami.0c17729
Melanie A. Jenkins 1 , Konner E. K. Holden 1 , Sean W. Smith 2 , Michael T. Brumbach 2 , M. David Henry 2 , Conan Weiland 3 , Joseph C. Woicik 3 , Samantha T. Jaszewski 4 , Jon F. Ihlefeld 4, 5 , John F. Conley 1
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2021-03-22 , DOI: 10.1021/acsami.0c17729
Melanie A. Jenkins 1 , Konner E. K. Holden 1 , Sean W. Smith 2 , Michael T. Brumbach 2 , M. David Henry 2 , Conan Weiland 3 , Joseph C. Woicik 3 , Samantha T. Jaszewski 4 , Jon F. Ihlefeld 4, 5 , John F. Conley 1
Affiliation
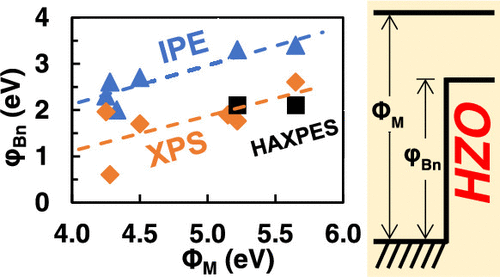
|
Doped ferroelectric HfO2 is highly promising for integration into complementary metal-oxide semiconductor (CMOS) technology for devices such as ferroelectric nonvolatile memory and low-power field-effect transistors (FETs). We report the direct measurement of the energy barriers between various metal electrodes (Pt, Au, Ta, TaN, Ti/Pt, Ni, Al) and hafnium zirconium oxide (Hf0.58Zr0.42O2, HZO) using internal photoemission (IPE) spectroscopy. Results are compared with valence band offsets determined using the three-sample X-ray photoelectron spectroscopy (XPS) as well as the two-sample hard X-ray photoelectron spectroscopy (HAXPES) techniques. Both XPS and IPE indicate roughly the same dependence of the HZO barrier on metal work function with a slope of 0.8 ± 0.5. XPS and HAXPES-derived barrier heights are on average about 1.1 eV smaller than barrier heights determined by IPE, suggesting the presence of negative charge in the HZO.
中文翻译:

使用内部光发射光谱法和X射线光电子能谱法测定Ox氧化锆界面能带对准
对于铁电非易失性存储器和低功率场效应晶体管(FET)等设备,掺杂铁电HfO 2有望集成到互补金属氧化物半导体(CMOS)技术中。我们报告了直接测量各种金属电极(Pt,Au,Ta,TaN,Ti / Pt,Ni,Al)和氧化z锆(Hf 0.58 Zr 0.42 O 2,HZO)使用内部光发射(IPE)光谱。将结果与使用三样品X射线光电子能谱(XPS)和两样品硬X射线光电子能谱(HAXPES)技术确定的价带偏移进行比较。XPS和IPE都表明HZO势垒对金属功函数的依赖性大致相同,斜率为0.8±0.5。XPS和HAXPES衍生的势垒高度平均比IPE确定的势垒高度小约1.1 eV,这表明HZO中存在负电荷。
更新日期:2021-03-31
中文翻译:

使用内部光发射光谱法和X射线光电子能谱法测定Ox氧化锆界面能带对准
对于铁电非易失性存储器和低功率场效应晶体管(FET)等设备,掺杂铁电HfO 2有望集成到互补金属氧化物半导体(CMOS)技术中。我们报告了直接测量各种金属电极(Pt,Au,Ta,TaN,Ti / Pt,Ni,Al)和氧化z锆(Hf 0.58 Zr 0.42 O 2,HZO)使用内部光发射(IPE)光谱。将结果与使用三样品X射线光电子能谱(XPS)和两样品硬X射线光电子能谱(HAXPES)技术确定的价带偏移进行比较。XPS和IPE都表明HZO势垒对金属功函数的依赖性大致相同,斜率为0.8±0.5。XPS和HAXPES衍生的势垒高度平均比IPE确定的势垒高度小约1.1 eV,这表明HZO中存在负电荷。































 京公网安备 11010802027423号
京公网安备 11010802027423号