当前位置:
X-MOL 学术
›
ACS Appl. Electron. Mater.
›
论文详情
Our official English website, www.x-mol.net, welcomes your feedback! (Note: you will need to create a separate account there.)
电极应用氮化钛薄膜原子层沉积中的替代表面反应路线
ACS Applied Electronic Materials ( IF 4.3 ) Pub Date : 2021-02-05 , DOI: 10.1021/acsaelm.0c01079 Hyeok Jae Lee 1 , Jin Ha Hwang 1 , Ji-Yong Park 1 , Sang Woon Lee 1
ACS Applied Electronic Materials ( IF 4.3 ) Pub Date : 2021-02-05 , DOI: 10.1021/acsaelm.0c01079 Hyeok Jae Lee 1 , Jin Ha Hwang 1 , Ji-Yong Park 1 , Sang Woon Lee 1
Affiliation
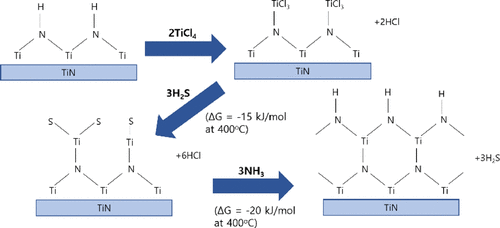
|
通过原子层沉积(ALD)生长的氮化钛(TiN)薄膜作为半导体器件应用中的电极材料引起了相当大的关注,例如逻辑晶体管和动态随机存取存储器(DRAM)。TiCl 4和NH 3主要用作TiN ALD工艺的Ti前体和氮源。不幸的是,TiN膜的电阻率随着ALD工艺温度的降低而增加。在ALD工艺温度低于400°C时,TiN膜的电阻率尤其显着提高(> 150μΩ·cm),这是因为剩余的Cl杂质(> 3%)来自TiCl 4前体。因此,需要高于500℃的处理温度以实现TiN膜的低电阻率。在这项研究中,我们提供了一种新颖的ALD方法以通过新颖的ALD表面反应途径降低TiN膜电阻率的首次演示。结果,与传统的TiCl 4 + NH 3 ALD工艺相比,在给定的ALD工艺温度(〜<400°C)下获得了更低的电阻率(<130μΩ·cm)。在TiCl 4脉冲后引入H 2 S以形成硫化钛,然后通过以下NH 3将其转化为氮化钛。气体。通过建议的反应途径,与使用常规TiCl 4 + NH 3 ALD工艺的TiN薄膜相比,在给定的生长温度下,TiN薄膜的电阻率降低了20%以上。由于在ALD表面反应过程中H 2 S的作用,TiN膜中的Cl杂质大大减少(〜1%),最终降低了TiN膜的电阻率。TiN膜的电阻率降低可以降低DRAM操作的功耗,从而为高密度集成提供了激进的DRAM电容器缩放比例。

"点击查看英文标题和摘要"
更新日期:2021-02-23

"点击查看英文标题和摘要"





































 京公网安备 11010802027423号
京公网安备 11010802027423号