当前位置:
X-MOL 学术
›
ACS Appl. Mater. Interfaces
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Vertically Graded Oxygen Deficiency for Improving Electrical Characteristics and Stability of Indium Gallium Zinc Oxide Thin-Film Transistors
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2021-01-15 , DOI: 10.1021/acsami.0c15017
Chan Sic Yoon 1 , Hyung Tae Kim 1 , Min Seong Kim 1 , Hyukjoon Yoo 1 , Jeong Woo Park 1 , Dong Hyun Choi 1 , Dongwoo Kim 1 , Hyun Jae Kim 1
ACS Applied Materials & Interfaces ( IF 8.3 ) Pub Date : 2021-01-15 , DOI: 10.1021/acsami.0c15017
Chan Sic Yoon 1 , Hyung Tae Kim 1 , Min Seong Kim 1 , Hyukjoon Yoo 1 , Jeong Woo Park 1 , Dong Hyun Choi 1 , Dongwoo Kim 1 , Hyun Jae Kim 1
Affiliation
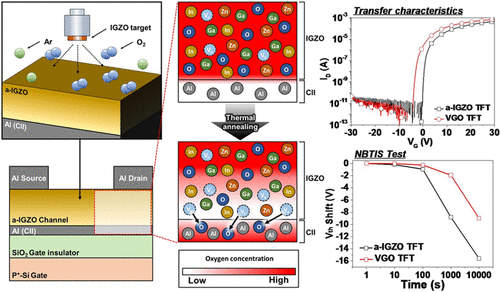
|
We investigated a facile fabrication method, which is an insertion of a carrier-induced interlayer (CII) between the oxygen-rich a-IGZO channel and the gate insulator to improve the electrical characteristics and stability of amorphous indium–gallium–zinc–oxide thin-film transistors (a-IGZO TFTs). The a-IGZO channel is deposited with additional oxygen gas flow during a-IGZO channel deposition to improve the stability of the a-IGZO TFTs. The CII is a less than 10 nm thick deposited thin film that acts to absorb the oxygen from the a-IGZO front channel through oxidation. Through oxidation of the CII, the oxygen concentration of the a-IGZO front channel is decreased compared to that of the oxygen-rich back channel, which forms a vertically graded oxygen deficiency (VGO) in the a-IGZO channel. Therefore, the electrical characteristics of the VGO TFTs are improved by increasing the carrier concentration of the front channel as the oxygen vacancy concentration in the front channel is increased through the oxidation of the CII. At the same time, the stability of the VGO TFTs is improved by maintaining a high oxygen concentration in the back channel even after oxidation of the CII. The field-effect mobility (μFET) of the VGO TFTs improved compared to that of the a-IGZO TFTs from 7.16 ± 0.6 to 12.0 ± 0.7 cm2/V·s. The threshold voltage (Vth) shifts under positive bias temperature stress and negative bias temperature illumination stress decreased from 6.00 to 2.95 V and −15.58 to −8.99 V, respectively.
中文翻译:

垂直梯度缺氧改善了铟镓锌氧化物薄膜晶体管的电气特性和稳定性
我们研究了一种简便的制造方法,该方法是在富氧的a-IGZO通道和栅极绝缘体之间插入载流子诱导的中间层(CII),以改善非晶态铟镓锌锌氧化物薄膜的电特性和稳定性。膜晶体管(a-IGZO TFT)。在a-IGZO沟道沉积过程中,在a-IGZO沟道中沉积了额外的氧气,以提高a-IGZO TFT的稳定性。CII是厚度小于10 nm的沉积薄膜,其作用是通过氧化从a-IGZO前通道吸收氧。与富氧的后通道相比,通过CII的氧化,a-IGZO前通道的氧浓度降低了,这在a-IGZO通道中形成了垂直分级的氧缺乏(VGO)。因此,当通过CII的氧化增加前沟道中的氧空位浓度时,通过增加前沟道的载流子浓度可以改善VGO TFT的电特性。同时,即使在CII氧化后,通过在背沟道中保持高氧浓度也可以提高VGO TFT的稳定性。场效应迁移率(μ与a-IGZO TFT相比,VGO TFT的FET从7.16±0.6提高到12.0±0.7 cm 2 / V·s。在正偏压温度应力和负偏压温度照明应力下,阈值电压(V th)分别从6.00降低到2.95 V,从-15.58降低到-8.99V。
更新日期:2021-01-27
中文翻译:

垂直梯度缺氧改善了铟镓锌氧化物薄膜晶体管的电气特性和稳定性
我们研究了一种简便的制造方法,该方法是在富氧的a-IGZO通道和栅极绝缘体之间插入载流子诱导的中间层(CII),以改善非晶态铟镓锌锌氧化物薄膜的电特性和稳定性。膜晶体管(a-IGZO TFT)。在a-IGZO沟道沉积过程中,在a-IGZO沟道中沉积了额外的氧气,以提高a-IGZO TFT的稳定性。CII是厚度小于10 nm的沉积薄膜,其作用是通过氧化从a-IGZO前通道吸收氧。与富氧的后通道相比,通过CII的氧化,a-IGZO前通道的氧浓度降低了,这在a-IGZO通道中形成了垂直分级的氧缺乏(VGO)。因此,当通过CII的氧化增加前沟道中的氧空位浓度时,通过增加前沟道的载流子浓度可以改善VGO TFT的电特性。同时,即使在CII氧化后,通过在背沟道中保持高氧浓度也可以提高VGO TFT的稳定性。场效应迁移率(μ与a-IGZO TFT相比,VGO TFT的FET从7.16±0.6提高到12.0±0.7 cm 2 / V·s。在正偏压温度应力和负偏压温度照明应力下,阈值电压(V th)分别从6.00降低到2.95 V,从-15.58降低到-8.99V。

































 京公网安备 11010802027423号
京公网安备 11010802027423号