当前位置:
X-MOL 学术
›
Appl. Surf. Sci.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
表面污染层对超薄HfO 2薄膜厚度测量的影响
Applied Surface Science ( IF 6.3 ) Pub Date : 2021-01-11 , DOI: 10.1016/j.apsusc.2021.148982
Tae Gun Kim , Hyunung Yu , Seung Mi Lee , Gyea Young Kwak , Jiyoung Shin , Kyung Joong Kim

"点击查看英文标题和摘要"
更新日期:2021-01-20
Applied Surface Science ( IF 6.3 ) Pub Date : 2021-01-11 , DOI: 10.1016/j.apsusc.2021.148982
Tae Gun Kim , Hyunung Yu , Seung Mi Lee , Gyea Young Kwak , Jiyoung Shin , Kyung Joong Kim
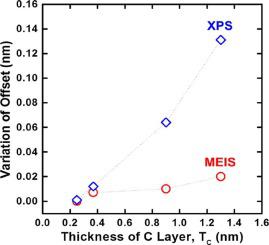
|
建议通过零偏移量方法(ZOM)和长度单位可追溯方法(LTM)的组合进行相互校准,作为确定超薄氧化膜真实厚度的方法。尽管建议将中能离子散射光谱(MEIS)和X射线光电子能谱(XPS)作为ZOM,但厚度的偏移值会受到表面污染层的影响。
在这项研究中,我们比较了表面污染层对通过MEIS和XPS测量一系列HfO 2膜的厚度的影响。HfO 2膜的表面被厚度为0.25 nm至1.30 nm的薄碳层污染。在MEIS中,表面碳层的偏移值的变化在0.020nm的范围内可以忽略不计。但是,在XPS中它在0.131 nm的范围内很大。总之,MEIS可以作为可靠的ZOM来校准超薄氧化膜厚度测量中的偏移值,而对表面污染的影响可忽略不计。

"点击查看英文标题和摘要"

































 京公网安备 11010802027423号
京公网安备 11010802027423号