当前位置:
X-MOL 学术
›
Plasma Processes Polym.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
微波等离子体预处理SiH4气体对热CVD硅膜形成行为的影响
Plasma Processes and Polymers ( IF 2.9 ) Pub Date : 2020-01-27 , DOI: 10.1002/ppap.201900198
Keiichi Hamanaka 1 , Norihisa Takei 1 , Hiroaki Kakiuchi 1 , Kiyoshi Yasutake 1, 2 , Hiromasa Ohmi 1, 2
Plasma Processes and Polymers ( IF 2.9 ) Pub Date : 2020-01-27 , DOI: 10.1002/ppap.201900198
Keiichi Hamanaka 1 , Norihisa Takei 1 , Hiroaki Kakiuchi 1 , Kiyoshi Yasutake 1, 2 , Hiromasa Ohmi 1, 2
Affiliation
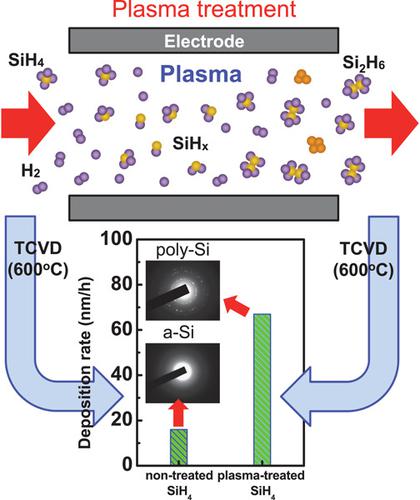
|
我们提出了一种通过高密度等离子体对甲硅烷(SiH 4)气体进行预处理的方法,该方法是通过热化学气相沉积(TCVD)在较低温度下形成结晶硅膜(≤600°C)。通过气相傅立叶变换红外光谱研究了SiH 4与等离子体的反应行为。研究了Si 2 H 6形成特性对总气体流量和输入微波功率的依赖性。等离子体处理的SiH 4气体的Si 2 H 6气体产率随着输入微波功率的降低而增加,并随着总气体流速的增加而增加。使用等离子处理的SiH通过TCVD制备Si膜4气。结果,高密度等离子体对SiH 4气体的预处理不仅影响沉积速率,而且影响所得Si膜的结晶度。讨论了通过等离子体处理改善硅膜形成的机理。

"点击查看英文标题和摘要"
更新日期:2020-01-27

"点击查看英文标题和摘要"

































 京公网安备 11010802027423号
京公网安备 11010802027423号