当前位置:
X-MOL 学术
›
J. Phys. Chem. Lett.
›
论文详情
Our official English website, www.x-mol.net, welcomes your
feedback! (Note: you will need to create a separate account there.)
Vanadium Dioxide by Atomic Layer Deposition: A Promising Material for Next-Generation Memory Devices
The Journal of Physical Chemistry Letters ( IF 4.8 ) Pub Date : 2024-09-18 , DOI: 10.1021/acs.jpclett.4c02192 Thomas Ratier 1 , Salomé Rigollet 1 , Paolo Martins 1 , Patrick Garabedian 1 , Etienne Eustache 1 , David Brunel 1
The Journal of Physical Chemistry Letters ( IF 4.8 ) Pub Date : 2024-09-18 , DOI: 10.1021/acs.jpclett.4c02192 Thomas Ratier 1 , Salomé Rigollet 1 , Paolo Martins 1 , Patrick Garabedian 1 , Etienne Eustache 1 , David Brunel 1
Affiliation
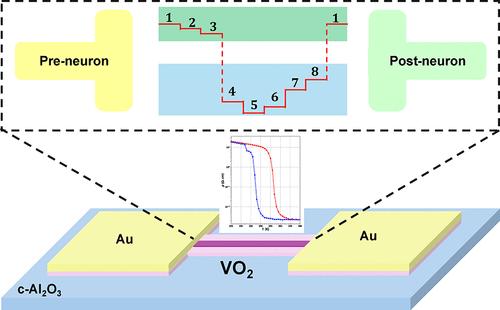
|
The synthesis of a vanadium dioxide (VO2) film using atomic layer deposition (ALD) with vanadium tetrachloride (VCl4) as a precursor for the realization of programmable memory devices is reported. X-ray diffraction analysis revealed the epitaxial growth of VO2 on c-Al2O3. The phase transition was monitored using resistivity measurements across varying temperatures, demonstrating a decrease of >4 orders of magnitude at the transition temperature, thereby confirming the high quality of the material. From this material, memristive devices are fabricated as resistive random-access memory (RRAM). On the basis of spiking voltage inputs, these RRAM exhibited cycle stability over 512 cycles and state retention stability for >450 s, showing <2% drift. With respect to synaptic-like applications, the RRAM devices were piloted through step patterns to enable multilevel memory states. These ALD-grown VO2-based devices demonstrate potential for use as synaptic connections with multiweight synapses, advancing scalability in neuromorphic applications.
中文翻译:

原子层沉积二氧化钒:下一代存储器件的有前途的材料
据报道,使用原子层沉积(ALD)以四氯化钒(VCl 4 )作为前体合成二氧化钒(VO 2 )薄膜,用于实现可编程存储器件。 X射线衍射分析表明VO 2在c-Al 2 O 3上外延生长。使用不同温度下的电阻率测量来监测相变,证明在相变温度下电阻率降低了 >4 个数量级,从而证实了材料的高质量。利用这种材料,忆阻器件被制造为电阻式随机存取存储器(RRAM)。基于尖峰电压输入,这些 RRAM 表现出超过 512 个周期的循环稳定性和 >450 秒的状态保持稳定性,显示出 <2% 漂移。对于类似突触的应用,RRAM 器件通过步进模式进行试点,以实现多级存储状态。这些基于 ALD 生长的 VO 2器件展示了用作多权重突触突触连接的潜力,从而提高了神经形态应用中的可扩展性。
更新日期:2024-09-18
中文翻译:

原子层沉积二氧化钒:下一代存储器件的有前途的材料
据报道,使用原子层沉积(ALD)以四氯化钒(VCl 4 )作为前体合成二氧化钒(VO 2 )薄膜,用于实现可编程存储器件。 X射线衍射分析表明VO 2在c-Al 2 O 3上外延生长。使用不同温度下的电阻率测量来监测相变,证明在相变温度下电阻率降低了 >4 个数量级,从而证实了材料的高质量。利用这种材料,忆阻器件被制造为电阻式随机存取存储器(RRAM)。基于尖峰电压输入,这些 RRAM 表现出超过 512 个周期的循环稳定性和 >450 秒的状态保持稳定性,显示出 <2% 漂移。对于类似突触的应用,RRAM 器件通过步进模式进行试点,以实现多级存储状态。这些基于 ALD 生长的 VO 2器件展示了用作多权重突触突触连接的潜力,从而提高了神经形态应用中的可扩展性。











































 京公网安备 11010802027423号
京公网安备 11010802027423号