EEM |中国科学院物理研究所陈小龙教授:高品质晶圆级立方碳化硅单晶
本文来源于Energy & Environmental Materials,欢迎浏览!
亮点
1.提出了通过调控熔体表面张力,在异质籽晶上较同质籽晶优先形核和生长的学术思想,实现了立方碳化硅(3C-SiC)在六方籽晶(4H-SiC)的晶体生长。
2.首次生长了高质量、直径2-4英寸、厚度为4-10 mm单一晶型的3C-SiC单晶,解决了3C-SiC单晶生长的难题。
3.高质量、晶圆级3C-SiC单晶的成功生长为制备比4H-SiC基金属氧化物半导体场效应晶体管(MOSFET)更高可靠性、更高稳定性和更长寿命的MOSFET奠定了基础,有望解决SiC-MOSFET的痛点,加速其在电动汽车等领域上的应用。
研究背景
碳化硅(SiC)是一种宽带隙化合物半导体,具有高击穿场强(约为Si的10倍)、高饱和电子漂移速率(约为Si的2倍)、高热导率(Si的3倍、GaAs的10倍)等优异性能。相比同类Si基器件,SiC器件具有耐高温、耐高压、高频特性好、转化效率高、体积小和重量轻等优点,在电动汽车、轨道交通高压输变电、光伏、5G通讯等领域具有应用潜力。
虽然SiC具有200多种晶型,但商业化的器件如电动汽车、光伏工业和其他应用的核心器件:金属-氧化物-半导体场效应晶体管(MOSFET)主要制备在六方4H-SiC单晶衬底上,这是因为采用目前最成熟的物理气相传输(PVT)法可以实现4H-SiC单晶衬底的大规模产业化生长。但是,SiCMOSFET功率器件存在栅氧界面可靠性差、载流子迁移率低、欧姆接触差等问题。与4H-SiC相比3C-SiC具有更低的界面缺陷态密度、更高的理论和实际载流子迁移率、更高的热导率。因此,基于3C-SiC的MOSFET器件具有更高的可靠性、更长的寿命和更高的稳定性,有望解决SiC-MOSFET功率器件的行业痛点。
尽管研究人员一直致力于晶圆级、高质量3C-SiC单晶生长的研究,以制备用于电动汽车等的MOSFET器件,但都没有获得大的突破,主要是3C-SiC很容易转变为其它晶型。获得单一晶型的3C-SiC单晶难度大,制约了3C-SiC基器件的发展。为了获得3C-SiC基器件,目前常用的方法是在Si衬底上外延生长3C-Si℃,但由于Si与3C-SiC大的晶格失配和热膨胀系数失配导致高的缺陷密度影响了3C-SiC基器件的性能。
为解决晶圆级3C-SiC单晶生长的技术难题,中国科学院物理研究所的陈小龙团队创新地提出了通过调控熔体表面张力,在异质籽晶上较同质籽晶优先形核和生长的学术思想,利用顶部籽晶溶液生长法(TSSG)在国际上首次成功生长了2-4英寸、高质量3C-SiC单晶。(111)生长面的X射线摇摆曲线半高宽的平均值为:30 arcsec。3C-SiC单晶中存在堆垛层错,螺位错和刃位错缺陷,堆垛层错的密度为92.2 cm-1。3C-SiC单晶的室温电阻率只有0.58 mQ·cm,为商业化4H-SiC晶片电阻率(15-28 mΩ·cm)的~1/4。高质量、晶圆级、大厚度、低电阻率3C-SiC单晶衬底的成功制备填补了国际空白,将有助于增强我国在SiC单晶衬底的国际领跑地位,极大推进3C-SiC基MOSFET器件的发展,提高器件的性能,降低成本,促进我国宽禁带半导体产业的快速发展。更重要的是,TSSG技术可以实现高质量、晶圆级、厚度4-10 mm的3C-SiC单晶长时间的稳定生长,说明TSSG在产业化上的应用潜力和优势。
文章简读
采用TSSG法在国际上首次生长了高质量、晶圆级、单一晶型的3C-SiC单晶。通过Raman对晶体的晶型进行了表征,说明晶体中只有3C-SiC晶型,不存在其他晶型,光致发光(PL)和透射电子显微镜(TEM)进一步证实了生长的晶体为3C-SiC。Raman表征说明3C-SiC-开始就在4H-SiC籽晶上形核、然后稳定生长。X射线测试结果说明生长面为(111)晶面,X射线摇摆曲线测试结果证明(111)晶面的X射线摇摆曲线半高宽的平均值为:30 arcsec,说明生长的晶体具有高的结晶质量。在1850°C测量了助溶剂的表面张力、4H-SiC/助溶剂、4H-SiC/助溶剂之间接触角,基于杨氏方程计算了4H-SiC/熔体、3C-SiC/熔体之间的界面能,证明了3C-SiC在4H-SiC籽晶上的异质形核优于4H-SiC在4H-SiC籽晶上的台阶流生长模式。此生长策略拓展了传统的晶体生长理论,有望生长出新的晶体材料。
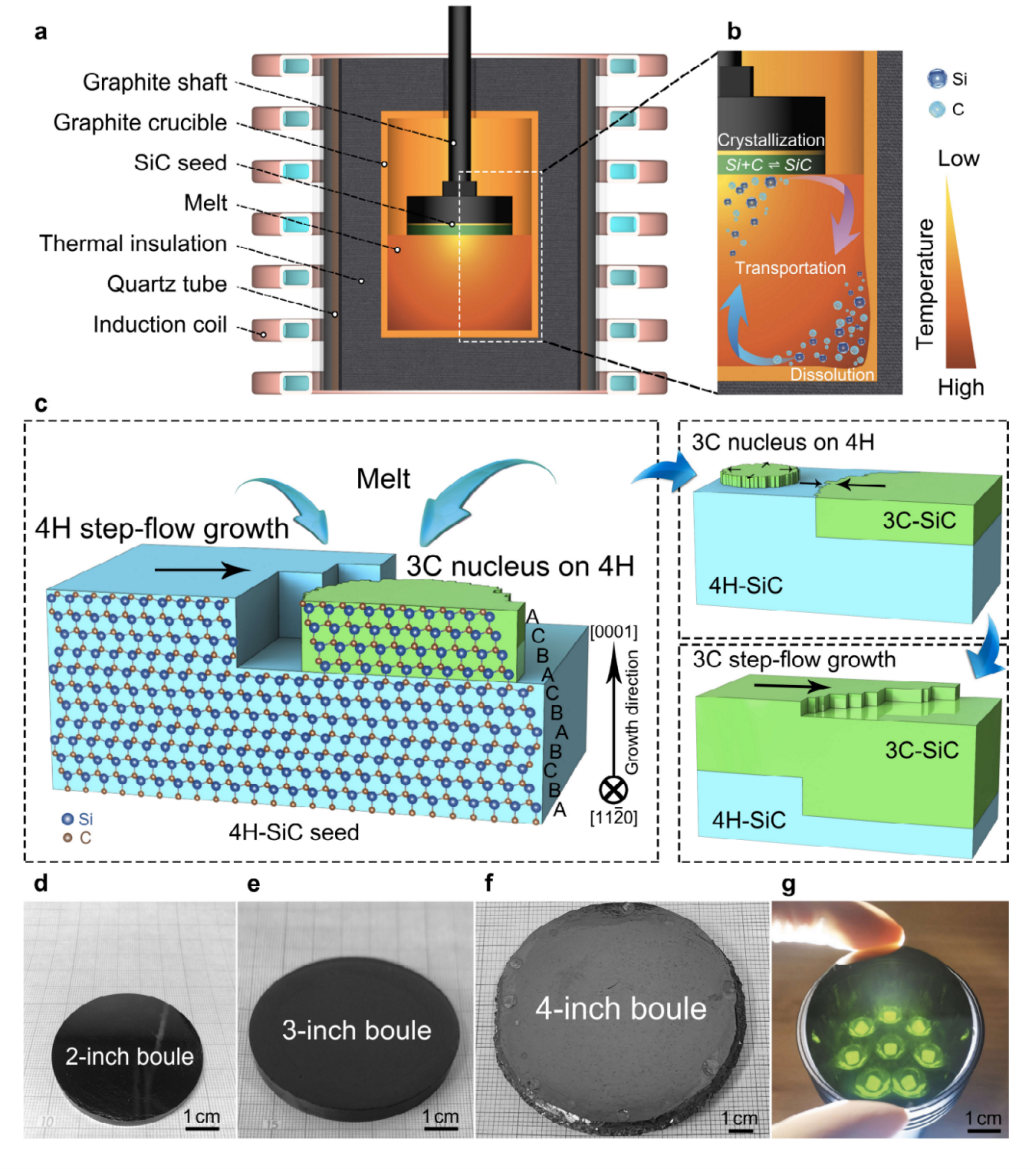
图 1.采用TSSG法生长3C-SiC单晶。a)采用TSSG法生长3C-SiC单晶的示意图。b) TSSG法生长SiC单晶的三个过程示意图:1.在高温区,熔体溶解石墨坩埚的C,2.在对流作用下,C从高温区输运到位于低温区的籽晶处,3SiC在位于低温区的籽晶上结晶,实现SiC单晶的生长。c)采用TSSG法在4H-SiC籽晶上生长3C-SiC单晶的原理示意图。d-f)生长的2-4英寸3C-SiC单晶晶锭照片图。2英寸和3英寸SiC为外圆加工后晶锭的照片。4英寸SiC为生长后的晶锭照片图。晶锭的厚度在4 mm以上。g)3C-SiC单晶晶片的照片图
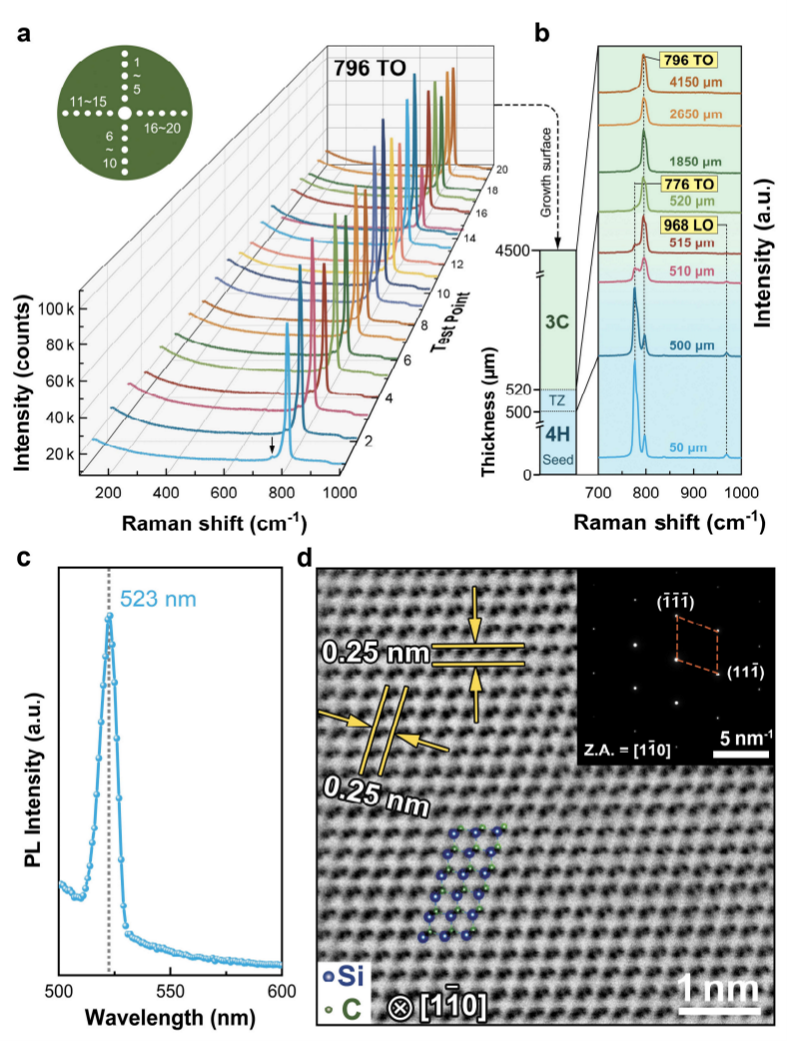
图 2.3C-SiC单晶晶型的确认。a) 在生长的2英寸晶锭上随机取20点后测得Raman图,插图给出了所取20个点在晶锭上的位置分布图。b)4H-SiC、过渡区、生长3C-SiC单晶的Raman图。c)300K测量的生长晶体的光致发光(PL)图谱。d)3C-SiC单晶的高角环形暗场透射电镜图(HAADF-STEM)。插图为沿着[1-10]晶体轴的选区电子衍射图(SAED)。

图 3.3C-SiC晶片结晶质量和缺陷表征。a)3C-SiC晶片X射线衍射图(XRD),说明生长面为(111)面。b)3C-SiC晶片(111)面随机9个点的X射线摇摆曲线(XRC),X射线摇摆曲线的半高宽的值为28.8-32.4 arcsec。插图给出了测量的9个点在晶片上的分布图。c-f)在熔融的KOH中腐蚀后的3C-SiC晶片的光学照片图(Optical microscope)腐蚀条件为:500 ℃,10 min。3C-SiC晶片中存在堆垛层错(stacking fault),螺位错(threading screwdislocations),和刃位错TEDs(threading edge dislocations缺陷。g,h)堆垛层错的HAADF-STEM图。
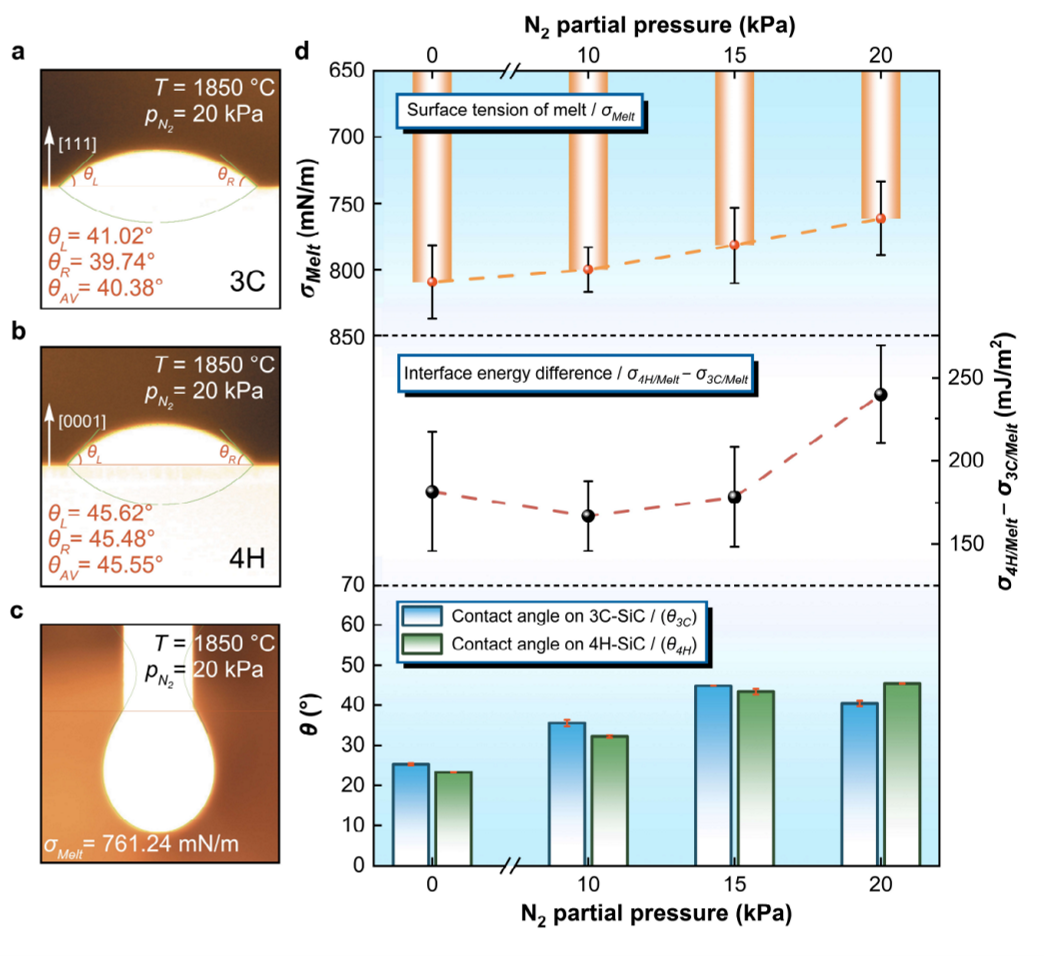
图 4.原位测量熔体的表面张力和与3C-SiC(111)、4H-SiC(0001)面的高温接触角。熔体4在a) 3C-SiC(111)表面和b) 半绝缘4H-SiC(0001)表面上的高温接触角测量图。接触角的平均值分别为40.38°+0.64°和45.55°+0.07°c)通过静滴法测量的熔体4的高温表面张力。d)熔体的高温表面张力柱状图(上图)、3C-SiC(111)和4HSiC(0001)面的高温接触角(下图)、熔体4与4H-SiC(0001)和3C-SiC(111)面的固-液界面能的差值(中图)。测量温度:1850°C,氮气分压0(熔体1),氮气分压10 kPa(熔体2),氨气分压15 kPa(熔体3)和氨气分压20 kPa(熔体A)

《能源与环境材料(英文)》(Energy & Environmental Materials)创刊于2018年,是由郑州大学和Wiley出版集团共同主办的国内外公开发行的英文期刊,主要报道能源捕获、转换、储存和传输材料以及洁净环境材料领域的高水平研究成果。EEM为材料、化学、物理、医学及工程等多学科及交叉学科的研究者提供交流平台,激发新火花、提出新概念、发展新技术、推进新政策,共同致力于清洁、环境友好的能源材料研发,促进人类社会可持续健康发展。期刊2022年度影响因子为15,JCI指数1.58,5年影响因子16.5,2022年度CiteScore为20.5,SNIP指标为2.425。在材料科学各领域位列前茅,其中科院分区为材料科学1区Top、材料科学综合1区。先后收录于DOAJ、SCIE、Scopus、CSCD等数据库。
如果篇首注明了授权来源,任何转载需获得来源方的许可!如果篇首未特别注明出处,本文版权属于 X-MOL ( x-mol.com ), 未经许可,谢绝转载!






























 京公网安备 11010802027423号
京公网安备 11010802027423号